芯片技術作為現代科技發展的核心驅動力,其制程工藝逼近物理極限,使得芯片三維異質集成來延續和拓展摩爾定律的重要性日趨凸顯。芯片三維互連技術及異質集成能夠將不同功能芯片在三維方向整合,提升芯片性能,為眾多領域提供高性能解決方案。在眾多技術探索中,金剛石因其卓越特性成為芯片技術發展的新希望。

芯片三維互連技術
通過垂直方向上的TSV/TGV技術與水平方向上的RDL技術的配合,對芯片進行三維互連,可將不同尺寸、材料、制程和功能的Chiplet異質集成到1個封裝體中。
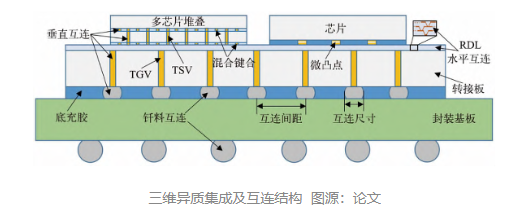
1、TSV技術:垂直互連的關鍵
TSV主要用于垂直方向信號連接,Cu-TSV 應用廣泛。其制造工藝包含深孔刻蝕、絕緣層及種子層形成、Cu填充和多余Cu去除等步驟。當前TSV直徑約10μm,深寬比約10∶1,未來有望縮小至直徑1μm、深寬比20∶1。然而,小尺寸TSV加工面臨絕緣層和種子層均勻性及Cu填充難題,相關工藝和材料特性研究有待深入。
2、TGV技術:低成本高潛力替代方案
TGV是TSV的低成本替代,具有高頻特性好、工藝流程簡單等優勢,在射頻、光電和 MEMS器件封裝領域前景廣闊。其工藝流程包括盲孔制備、種子層沉積和電鍍填充。激光誘導濕法刻蝕是常用成孔方法,但存在側壁垂直度差、深寬比小等問題,且 TGV電鍍填充方式與TSV不同,相關理論研究缺乏。
3、RDL技術:水平互連的核心
RDL實現芯片水平方向互連,通過晶圓級金屬布線工藝改變I/O焊盤位置和排列。目前高密度RDL線寬/線間距約6μm,微孔直徑20μm,但為提高I/O密度,需發展 1μm線寬/線間距和更小直徑微孔的RDL。實現高密度RDL面臨光刻、微孔加工、低介電常數材料和工藝選擇等關鍵問題。
異質集成方案
1、基于TSV及RDL的異質集成方案
晶圓級封裝:TSV用于傳感器封裝可減小尺寸、提高生產效率,硅基埋入扇出技術實現了芯片三維堆疊封裝,不同系統或功能芯片可集成在一個芯片中。
2016年,華天科技有限公司開發出硅基埋入扇出(eSiFO)技術,使用硅片作為載體,將芯片置于在12英寸硅晶圓上制作的高精度凹槽內,重構出1個晶圓;然后采用可光刻聚合物材料填充芯片和晶圓之間的間隙,在芯片和硅片表面形成扇出的鈍化平面;再通過光刻打開鈍化層開口,并采用晶圓級工藝進行布線和互連封裝。
2.5D TSV轉接板異質集成:2.5D TSV轉接板解決有機基板布線問題,實現多芯片高密度連接,臺積電CoWoS技術具代表性,已廣泛應用于高性能計算領域。
2011年,臺積電該技術通過芯片到晶圓工藝將芯片連接至硅轉接板上,再把堆疊芯片與基板連接,實現芯片-轉接板-基板的三維封裝結構。該技術采用前道工藝在轉接板上制作高密度的互連線,通過轉接板完成多個芯片的互連,可以大幅提高系統集成密度,降低封裝厚度。
典型2.5DTSV轉接板異質集成結構 圖源:論文
三維異質集成:基于TSV和微凸點的3D集成技術用于存儲芯片,后拓展到邏輯芯片堆疊,英特爾和三星推出相關技術并實現量產。
2019年,英特爾推出基于TSV和微凸點的新型3D集成技術Foveros,該技術能夠實現邏輯芯片的面對面堆疊,首次將芯片堆疊從傳統的無源中介層和內存等擴展到高性能邏輯芯片。
無凸點混合鍵合三維異質集成:無凸點Cu/絕緣層混合鍵合解決微凸點微型化瓶頸,臺積電SoIC技術實現超高密度垂直互連,但面臨設計規則、平整度等挑戰。
2015 年,索尼獲得Ziptronix 公司的混合鍵合技術授權,首次推出了基于無凸點混合鍵合的高性能圖像傳感器產品。半導體業界逐漸意識到混合鍵合將成為突破微凸點微型化瓶頸的有效途徑。
2、基于玻璃基板的異質集成方案
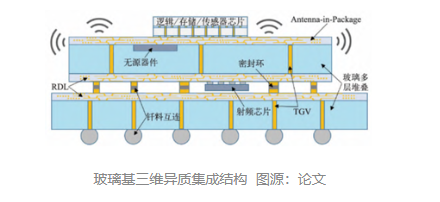
TGV及RDL異質集成:玻璃基板在傳輸性能、布線和成本上具優勢,基于TGV及 RDL的異質集成方案已用于多種芯片封裝,但玻璃散熱差,需改進散熱設計。
埋入玻璃式扇出型異質集成:佐治亞理工學院和本文作者團隊開發的相關技術實現邏輯和存儲芯片集成,在電源、超聲換能器和毫米波雷達芯片封裝中獲應用,提升芯片性能和集成度。
金剛石在三維互連技術及異質集成中的應用
金剛石/銅復合材料:通過在金剛石顆粒上設計雙層結構,采用真空熱壓法制備了高致密度、良好熱性能的金剛石/銅復合材料,改善了金剛石與銅基體之間的界面結合,獲得了高達721W/(m?K)的熱導率。
金剛石與硅基半導體的集成:華為通過Cu/SiO2混合鍵合技術將硅基與金剛石襯底材料進行三維集成,利用金剛石的高散熱性為三維集成的硅基器件提供散熱通道,提高器件的可靠性。
厚膜氮化鎵與多晶金剛石異質集成:中國科學院微電子研究所采用動態入射角度的等離子體拋光技術和原位硅納米層沉積輔助的離子束表面活化鍵合方法,實現了厚膜GaN與多晶金剛石的異質集成,鍵合率達~92.4%。
金剛石半導體芯片研發:Diamond Foundry培育全球首個單晶金剛石晶圓,旨在解決人工智能、云計算芯片、電動汽車電力電子器件和無線通信 芯片的熱挑戰。
總結
芯片三維互連和異質集成技術發展迅速,多種技術方案已應用或具應用潛力,但仍面臨諸多挑戰。金剛石的引入為芯片技術帶來新機遇,國內外研究和應用展示其在提升芯片性能和功能方面的巨大潛力。未來,期待金剛石在芯片領域的深入研究和廣泛應用,推動芯片技術實現新突破,為科技發展注入新動力。


 手機資訊
手機資訊 官方微信
官方微信








 豫公網安備41019702003604號
豫公網安備41019702003604號